近期,中國科學(xué)院半導(dǎo)體研究所科技成果轉(zhuǎn)化企業(yè)北京晶飛半導(dǎo)體科技在碳化硅晶圓加工技術(shù)領(lǐng)域取得重大突破,成功利用自主研發(fā)的激光剝離設(shè)備實現(xiàn)了12英寸碳化硅晶圓的剝離。該突破標(biāo)志著中國在第三代半導(dǎo)體關(guān)鍵制造裝備領(lǐng)域邁出重要一步,為全球碳化硅產(chǎn)業(yè)的降本增效提供了全新解決方案。
本次技術(shù)突破對碳化硅產(chǎn)業(yè)發(fā)展具有多重意義,主要包括:大幅降低生產(chǎn)成本:12英寸碳化硅晶圓相比目前主流的6英寸晶圓,可用面積提升約4倍,單位芯片成本降低30%—40%;提升產(chǎn)業(yè)供給能力:解決了大尺寸碳化硅晶圓加工的技術(shù)瓶頸,為全球碳化硅產(chǎn)能擴張?zhí)峁┝嗽O(shè)備保障;加速國產(chǎn)化替代進(jìn)程:打破了國外廠商在大尺寸碳化硅加工設(shè)備領(lǐng)域的技術(shù)壟斷,為我國半導(dǎo)體裝備自主可控提供了重要支撐;促進(jìn)下游應(yīng)用普及:成本降低將加速碳化硅器件在新能源汽車、可再生能源等領(lǐng)域的應(yīng)用。
轉(zhuǎn)載請注明出處。








 相關(guān)文章
相關(guān)文章
 熱門資訊
熱門資訊
 精彩導(dǎo)讀
精彩導(dǎo)讀









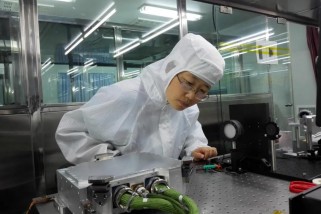









 關(guān)注我們
關(guān)注我們




